CoWoP 无基板先进封装引发关注,郭明錤称最乐观 2028 年量产
8 月 4 日消息,一项名为 cowop(chip on wafer on pcb)的先进封装技术近日在行业内引发广泛关注。

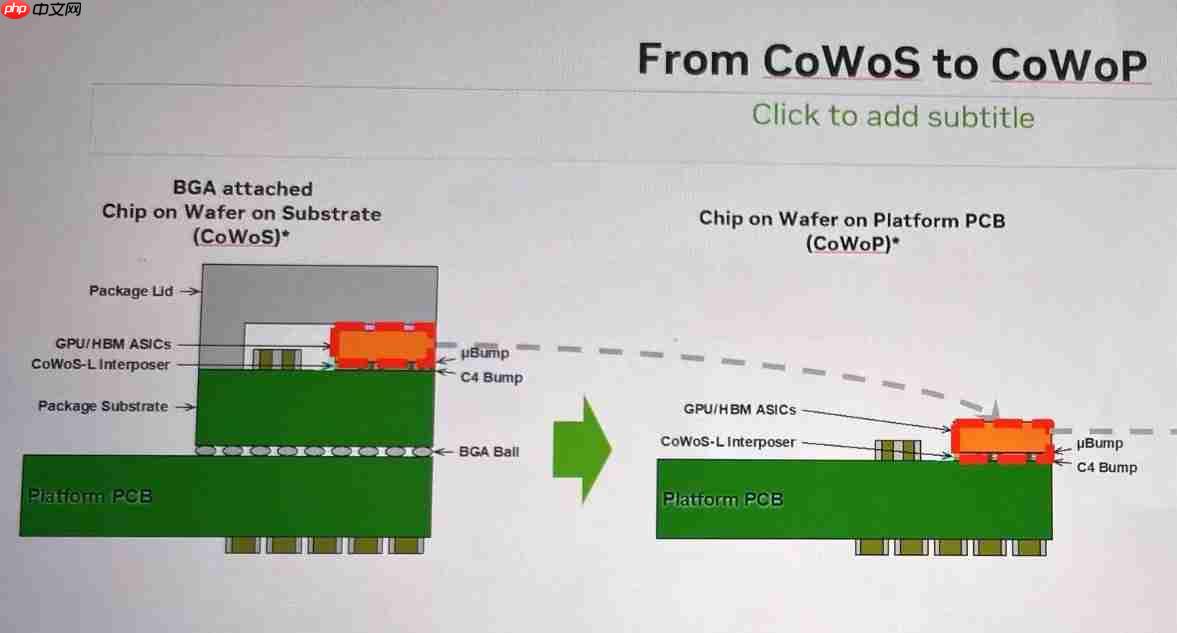
▲ 引自 X 平台用户 FerDino (@FDino98915)根据泄露的演示资料,CoWoP 是当前主流 2.5D 集成方案 CoWoS 的一种衍生技术。与 CoWoS 不同的是,CoWoP 取消了传统的独立基板(Substrate),转而采用高性能的基板级 PCB(Substrate-Level PCB, SLP)作为替代方案。

▲ 引自 X 平台用户 FerDino (@FDino98915)相关幻灯片指出,CoWoP 计划于今年 8 月在英伟达 GB100 超级芯片上开展功能性测试,全面评估其在各项性能指标上的可行性,并计划在 GR150 超级芯片项目中与 CoWoS 并行推进。
注:按照英伟达一贯的命名逻辑,GR100/150 应指代 Grace Rubin 100 / 150。然而根据此前官方信息,Rubin GPU 原本预期搭配 Vera CPU,而非 Grace 架构,因此 GR 系列超级芯片的具体构成仍有待确认。
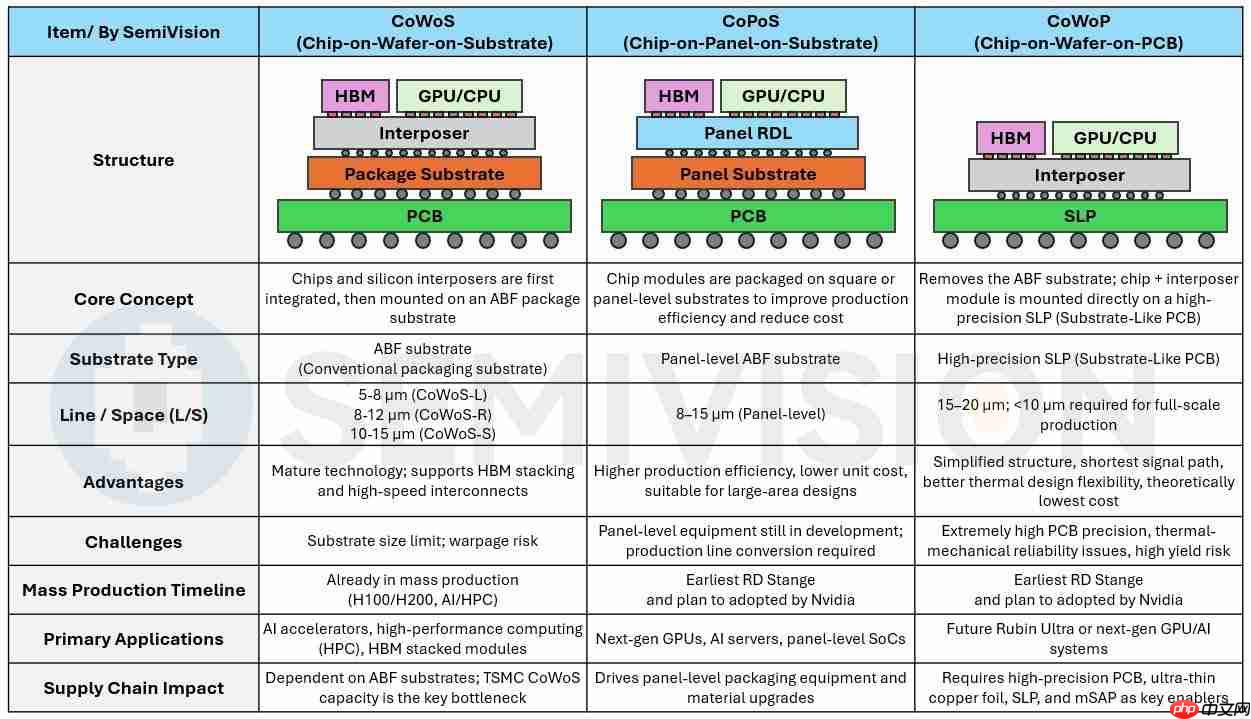
▲ 分析机构 SemiVision 整理的 CoWoS、CoPoS 与 CoWoP 技术对比据台媒《电子时报》报道,CoWoP 封装在信号完整性、电源管理、散热效率以及 PCB 热膨胀引起的翘曲控制方面优于传统 CoWoS,但在SLP 制造工艺、良率控制、系统可维护性、设计复杂度及技术迁移成本等方面仍面临显著挑战。
知名分析师郭明錤表示,预计 CoWoP 在 2028 年英伟达 Rubin Ultra 时代实现量产属于“较为乐观的预测”,主要原因包括高阶芯片对 SLP 生态链的严苛要求,以及 CoWoP 与 CoPoS 同步演进所带来的技术不确定性。

<< 上一篇
网友留言(0 条)